CMP设备及耗材对半导体硅片抛磨有影响吗?
CMP设备及耗材对半导体硅片抛磨影响吗?
CMP工艺离不开设备机台及耗材,其中耗材主要包括抛光垫slurry和抛光液Pad。
影响半导体晶圆CMP效果主要因素如下:
①设备参数:抛光时间、研磨盘转速、抛光头转速、抛光头摇摆度、背压、下压力等;
②研磨液参数:磨粒大小、磨粒含量、磨粒凝聚度、酸碱度、氧化剂含量、流量、粘滞系数等 ;
③抛光垫参数:硬度、密度、空隙大小、弹性等;
④CMP对象薄膜参数:种类、厚度、硬度、化学性质、图案密度等。
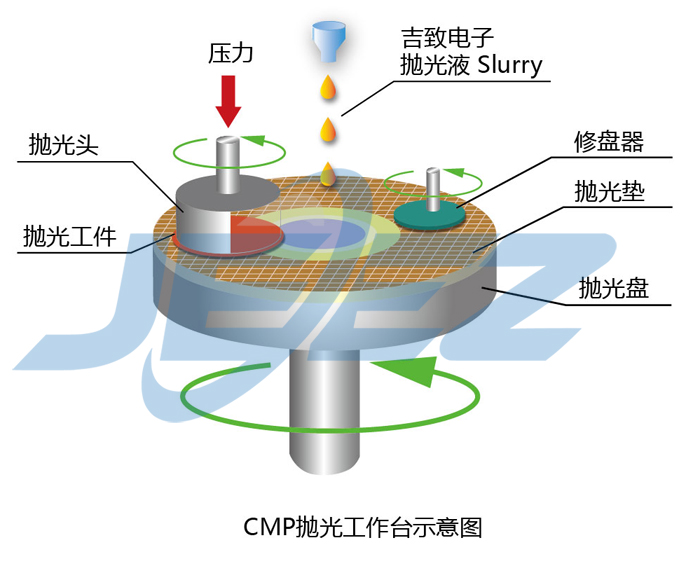
半导体晶圆CMP耗材包括抛光液、抛光垫、钻石碟、清洗液等,对CMP工艺效应有关键影响。
1. CMP抛光液:Slurry是研磨材料和化学添加剂的混合物,可使晶圆表面产生一层氧化膜,再由抛光液中的磨粒去除,达到抛光的目的。半导体抛光液的成分不同,抛磨效果也不同。
2. CMP抛光垫:Pad主要作用是储存和运输抛光液、去除磨屑和维持稳定的抛光环境等;
3. CMP钻石碟:是CMP工艺中必不可少的耗材,用于维持抛光垫表面一定的粗糙状态,通常与CMP抛光垫配套使用。
4. CMP清洗液:主要用于去除残留在晶圆表面的微尘颗粒、有机物、无机物、金属离子、氧化物等杂质,满足集成电路制造对清洁度的极高要求,对晶圆生产的良率起到了重要的作用。
本文由无锡吉致电子科技原创,版权归无锡吉致电子科技,未经允许,不得转载,转载需附出处及原文链接。http://www.jzdz-wx.com/
无锡吉致电子科技有限公司
联系电话:17706168670
邮编:214000
地址:江苏省无锡市新吴区新荣路6号
相关资讯
最新产品
同类文章排行
- 超硬材料精密抛光:吉致电子CMP金刚石研磨液
- CMP工艺在LED外延芯片制造中的优势及吉致电子CMP抛光耗材方案
- 吉致电子小科普:什么是硫系玻璃以及应用领域有哪些
- 吉致电子:CZT碲锌镉晶体CMP抛光崩边防控解决方案
- 吉致电子2026马年春节放假通知
- 不锈钢平面件CMP抛光液抛光垫选型指南
- 从硅基到第三代半导体:吉致电子CMP抛光液技术演进与全材料覆盖解决方案
- 蓝宝石衬底研磨抛光工艺与耗材方案|吉致电子CMP厂家
- 阻尼布抛光垫和聚氨酯抛光垫哪个好?
- 半导体CMP耗材G804W抛光垫国产替代认准吉致电子
最新资讯文章
您的浏览历史







