金属互连中的大马士革工艺
在半导体制程中为了连接不同的电路元件,传递电子信号和为电路元件供电,需要使用导电金属来形成互连结构。铝曾经是半导体行业中用于这些互联结构的主要材料。然而,随着半导体技术的进步和特征尺寸的不断缩小,铜成为了替代选择,那么这个过程是如何演变的呢?
金属互连工艺历史:早期的集成电路使用了金作为互连材料,到60-90年代中期,铝逐渐成为集成电路制造中最主要的互连导线材料。1997年,美国 IBM 公司公布了先进的铜互连技术,标志着铜正式开始替代铝成为高性能集成电路的主要互连材料。
IBM 公司首先提出了以铜作为互连材料的工艺方法,由于与2500多年前叙利亚大马士革城内铸剑工艺有异曲同工之妙,故以“大马士革”(Damascene)命名。如今大马士革工艺已经被广泛应用到了集成电路中。
通俗地讲,大马士革工艺就是在 Low-k 介质材料上刻蚀出凹痕并电镀铜的过程,并不会刻蚀较深的硅晶圆。最早的大马士革工艺称为铜质双重镶嵌,所谓“双重”,即需要刻蚀出通孔和沟槽两种形状,在这两种形状中溅射 Ti、Cu 种子层,再电镀出铜互连线,故该工艺也常被称为“双大马士革”(Dual-damascene)。
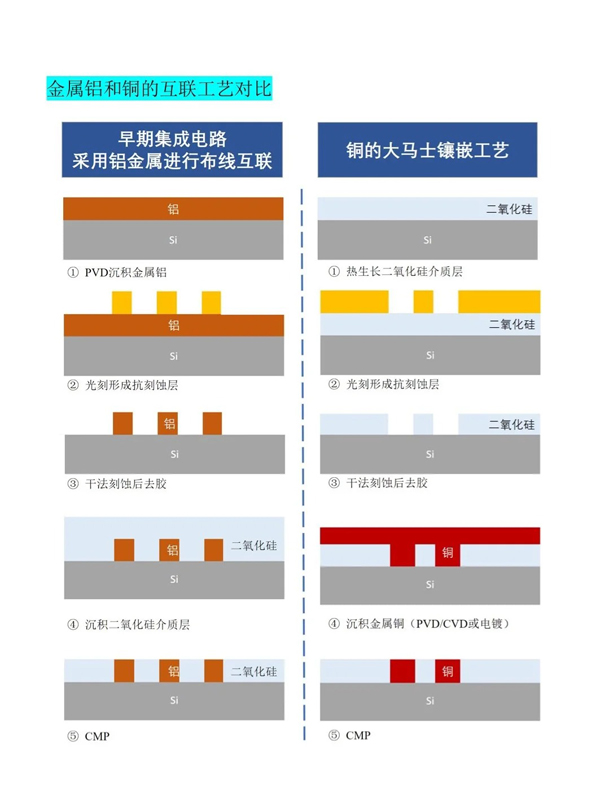
无锡吉致电子科技有限公司
联系电话:17706168670
邮编:214000
地址:江苏省无锡市新吴区新荣路6号
下一篇:衬底与晶圆在半导体制造中的应用上一篇:蓝宝石激光领域视窗抛光液
相关资讯
最新产品
同类文章排行
- 半导体晶圆常见材质有哪些
- 衬底与晶圆在半导体制造中的应用
- 金属互连中的大马士革工艺
- 蓝宝石激光领域视窗抛光液
- 半导体晶圆CMP化学机械研磨抛光的原因
- LT钽酸锂晶片的CMP抛光液
- 看懂SIC碳化硅衬底研磨加工技术
- 碳化硅衬底平坦化使用的是什么工艺?
- 碳化硅SIC衬底的加工难度有哪些?
- 氮化铝/氮化硅(AlN/SiN)陶瓷基板的研磨抛光
最新资讯文章
您的浏览历史







