CMP在半导体晶圆制程中的作用
化学机械抛光(CMP)是实现晶圆全局平坦化的关键工艺,通过化学腐蚀与机械研磨的协同配合作用,利用CMP抛光液、抛光机和抛光垫等CMP抛光研磨耗材实现晶圆表面多余材料的去除与纳米级全局平坦化。简单来讲,半导体晶圆制程可分为前道和后道 2 个环节。前道指晶圆的加工制造,后道工艺是芯片的封装测试。
前道加工领域CMP主要负责对晶圆表面实现平坦化。后道封装领域CMP 工艺用于先进封装环节的抛光。
晶圆制造前道加工环节主要包括 7 个相互独立的工艺流程:光刻、刻蚀、薄膜生长、扩散、离子注入、化学机械抛光、金属化 CMP 则主要用于衔接不同薄膜工艺,其中根据工艺段来分可以分为前段制程(FEOL)和后段制程(BEOL),前段制程工艺主要为 STI-CMP 和 Poly-CMP,后段制程工艺主要为介质层 ILD-CMP、IMD-CMP 以及金属层 W-CMP、Cu-CMP 等。
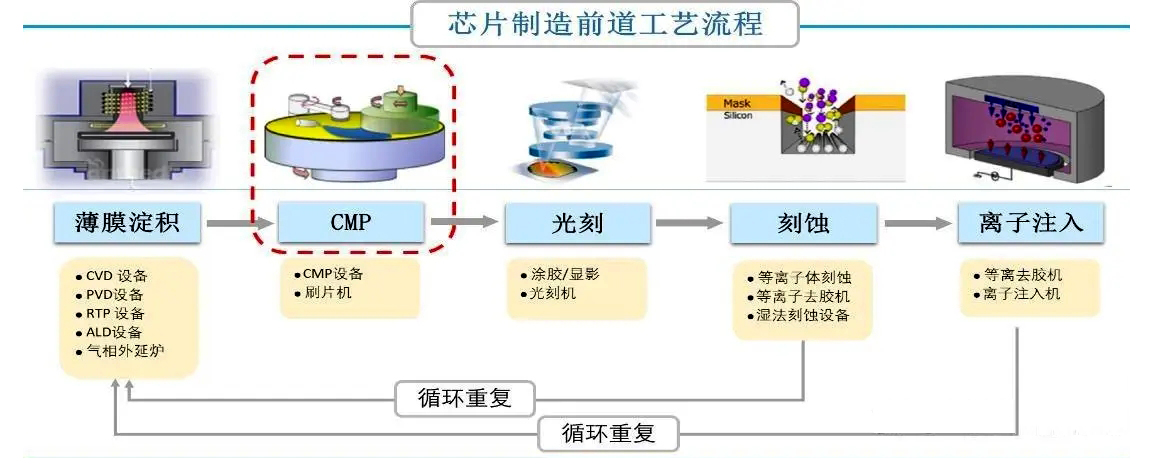
在后道封装领域:CMP 用于先进封装环节的抛光,如硅通孔(TSV)技术、 扇出(Fan-Out)技术、2.5D 转接板(interposer)、3D IC 等封装技术中对引线尺寸要求 更小更细,因此会引入刻蚀、光刻等工艺,而 CMP 作为每道工艺间的抛光工序,也得以广 泛应用于先进封装中。
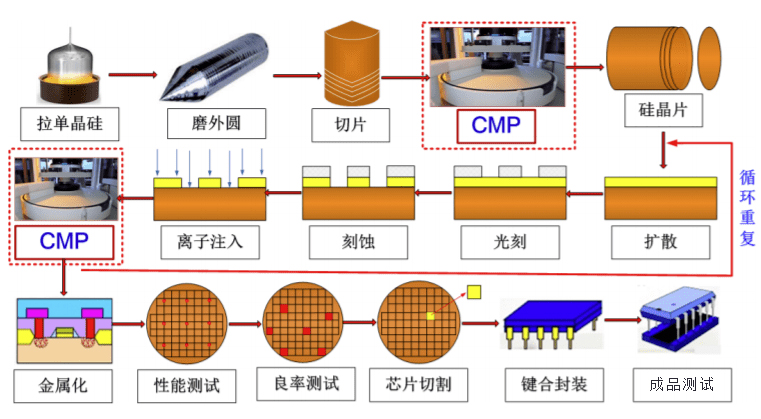
CMP技术利用磨损中的“软磨硬”原理,即用较软的材料来进行抛光以实现高质量的表面抛光,避免了由单纯机械抛光造成的表面损伤和由单纯化学抛光易造成的抛光速度慢、表面平整度和抛光一致性差等缺点。由此而见,CMP是先进集成电路制造前道工序、先进封装等环节必需的关键制程工艺。
吉致电子在半导体CMP抛光耗材方面有丰富的行业经验和成功案例,如碳化硅SIC抛光研磨液、Oxide氧化层抛光液、TSV CU铜抛光液等有成熟工艺方案和产品,欢迎咨询,吉致电子为您解决芯片晶圆抛光难题。
本文由无锡吉致电子科技原创,版权归无锡吉致电子科技,未经允许,不得转载,转载需附出处及原文链接。http://www.jzdz-wx.com/
无锡吉致电子科技有限公司
联系电话:17706168670
邮编:214000
地址:江苏省无锡市新吴区行创四路19-2
相关资讯
最新产品
同类文章排行
- 春和景明,匠心如常|吉致电子与春日共赴新程
- 吉致电子自研新突破:磷化铟衬底CMP抛光液半导体加工新升级
- 光学玻璃超精密抛光:吉致电子CMP抛光液客户案例解析
- DNA基因芯片精密制造——吉致电子CMP抛光液
- 吉致电子氧化铝抛光液:晶圆抛光精研致微超光滑表面
- 研磨液与抛光液的区别有哪些?
- 吉致电子钛合金专用CMP抛光液—高端制造的超精密抛光
- 什么是半导体CMP Slurry?
- 吉致电子:LN/LT晶体CMP抛光解决方案,赋能光子芯片与量子通信
- 吉致电子蓝宝石CMP研磨抛光及Template吸附垫加工方案
最新资讯文章
您的浏览历史







